SK海力士强化混合键合布局 力拼2027年16层HBM商用化
发布日期:2026-04-30
来源:芯智讯
据韩国媒体TheElec报道,在4月28日于韩国首尔举行的开云棋牌官网在线客服会议上,存储芯片大厂SK海力士(SK hynix)宣布其应用于高带宽内存(HBM)的混合键合(Hybrid Bonding)技术产量较两年前有显著提升。
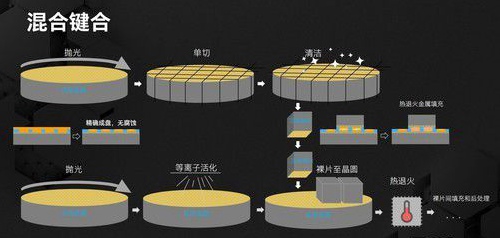
混合键合是一种先进的封装技术,通过直接连接芯片间的铜垫,省略了金属凸点或铜柱结构,不仅降低了热量生成,还显著提高数据传输速度,并允许更薄的堆叠高度。SK海力士技术领导人Kim Jong-hoon表示,该技术能实现比现有方法更细的互连间距。
尽管产量有所提升,Kim Jong-hoon也强调经济可行性仍是当前发展阶段的一大挑战。SK hynix计划继续利用其大规模重流模塑填充(MR-MUF)技术来解决这个问题,并表示不仅技术策略重要,价值同样关键。
随着HBM的演进,堆叠层数不断增加,制程复杂性急剧上升,推动封装技术持续创新。HBM封装技术已从热压非导电薄膜(TC-NCF)进展到MR-MUF,最终迈向混合键合。每一步都减少了翘曲并提高生产效率。
Kim Jong-hoon指出,公司已完成12层HBM堆叠的验证,并且在量产准备方面比过去更加充分。
业界观察人士预测,混合键合技术将于今年下半年或2027年随着16层HBM产品的商业化逐步推出,这将使SK hynix在HBM竞争中占据有利地位,特别是在AI内存需求日益增长的背景下。